Molekularstrahlepitaxie

Karl-Wilhelm Steinfieber
Engl. molecular beam epitaxy, Abk. MBE. Physikalisches Verfahren zur Epitaxie dünner, einkristalliner Halbleiterschichten auf geeigneten halbleitenden, semiisolierenden oder isolierenden Substraten. Die M. ist im Unterschied zu den wesentlich älteren chemischen Epitaxieverfahren wie Gasphasenepitaxie, Flüssigphasenepi-taxie ein physikalisches Aufdampfverfahren unter Ultrahochvakuumbedingungen. Durch Verdampfung in geheizten Tiegeln mit speziellen Öffnungen werden molekulare bzw. atomare Strahlen aus den Einzelelementen der herzustellenden chemischen Verbindung erzeugt, auf die Oberfläche eines Substrats mit einer bestimmten Kristallorientierung gerichtet und dort Atom für Atom aufgetragen. Die Epitaxieschichten selbst wachsen infolge Wechselwirkung der Molekularstrahlen mit der geheizten Substratoberfläche auf, wobei der Wachstumsvorgang weitgehend durch kinetische Parameter, wie Molekularstrahlfluß, Verweildauer der Strahlteilchen an der Wachstumsgrenzfläche und Haftkoeffizient, bestimmt wird. Grundlegende Vorteile im Vergleich mit herkömmlichen Verfahren bestehen darin, daß die Epitaxie bei relativ niedrigen Temperaturen und mit geringen Wachstumsgeschwindigkeiten erfolgt (etwa 0, 1 nms). Das Kristallwachstum kann abrupt begonnen und unterbrochen werden. Dadurch wird eine sehr genaue Kontrolle der Schichtdicke, der chemischen Zusammensetzung der Halbleiterschicht und ihres Dotierungsprofils über die gesamte Substratfläche ermöglicht. Mit der M. können folglich insbesondere extrem dünne Schichten (wenige Atomlagen) mit abrupten Übergängen sowie periodische Vielschichtstrukturen (Supergitter, HEMT) erzeugt werden. Bevorzugte Anwendungsgebiete der M. sind die Abscheidung ternärer und quatemärer III-V-Verbindungshalbleiter mit beliebiger, vorher bestimmbarer chemischer Zusammensetzung für optoelektronische und Mikrowellenbauelemente. Oberflächen- und Grenzflächenphysik
Die Molekularstrahlepitaxie (Molecular Beam Epitaxy, MBE) ist eine Methode zum atomlagengenauen Aufwachsen von kristallinen Festkörperschichten, die aus gerichteten Molekularstrahlen im Ultrahochvakuum (UHV) abgeschieden werden. Im Vergleich zu anderen Methoden der Epitaxie (z.B. chemische Gasphasenabscheidung) ermöglicht die MBE eine besonders gute Kontrolle der Wachstumsprozesse.
Geschichte
Die Molekularstrahlepitaxie wurde 1971 von A. Cho an den Bell Laboratories entwickelt. Ziel der Methode war von Anfang an die Produktion von definierten dünnen Kristallschichten und von Übergittern aus verschiedenen Halbleitern.
Grundprinzipien
Gegenüber anderen Techniken zur Herstellung von dünnen Schichten zeichnet sich die MBE vor allem durch zwei Eigenschaften aus:
· Die Materialzufuhr durch die Molekularstrahlen kann atomlagengenau reguliert werden, so dass besonders dünne, definierte Schichten aufgewachsen werden können. Der Preis hierfür ist aber eine relativ geringe Geschwindigkeit des Schichtwachstums, so dass die Herstellung von »dicken« Schichten (grösser als einige mm) extrem zeitaufwendig ist.
· Es können epitaktische Schichten hergestellt werden, die mit anderen Verfahren auf Grund der Existenz von Mischungslücken überhaupt nicht zugänglich wären.
· Die Arbeit mit Molekularstrahlen im UHV erlaubt eine besonders hohe Reinheit der gewachsenen Proben.
Möglichkeiten und Anwendungen
Mit der MBE können dünne Schichten von Materialien hergestellt werden, deren Eigenschaften sich stark von denen der entsprechenden Volumenkristalle unterscheiden. So wird beispielsweise innerhalb gewisser Grenzen dem aufgewachsenen Material zunächst die Kristallstruktur und die Gitterkonstante des Substratmaterials aufgeprägt (»pseudomorphes Wachstum«). Ab einer (von der Grösse der Gitterfehlanpassung abhängigen) Schichtdicke geht die Gitteranpassung jedoch verloren: es bilden sich Fehlstellen und Versetzungen, und die Kristallstruktur geht in die Volumenstruktur des aufgewachsenen Materials über.
Das Hauptanwendungsgebiet der MBE ist die Herstellungen von Heterostrukturen aus III-V-Halbleitern, wie sie beispielsweise für Halbleiterlaser (Diodenlaser), Hallsensoren und spezielle Hochleistungstransistoren (HBT, HEMT) eingesetzt werden.
Ein weiteres bedeutendes Anwendungsgebiet der MBE ist das Aufwachsen von Metallen auf Halbleitern oder Quarzsubstraten. Solche Strukturen werden in der Zukunft eventuell für Speichermedien und spezielle Halbleiterbauelemente von Interesse sein.
Inselwachstum
Bis vor kurzem war man beim MBE-Wachstum nur an glatten Schichten interessiert. Vor allem bei Materialien mit stark unterschiedlichen Gitterkonstanten bilden sich diese aber nur unter optimalen Bedingungen (Substrattemperatur, Schichtdicke,...). Andernfalls entstehen Versetzungen in der Schicht ,oder sie zerreisst sogar in einzelne »Wachstumsinseln«. Bei Wahl der richtigen Bedingungen (sog. Stranski-Krastanow-Wachstum) können diese Wachstumsinseln wiederum zur Herstellung von interessanten Halbleiter-Heterostrukturen ausgenützt werden; die dann entstehenden Cluster sind alle annähernd gleich gross und stellen gewissermassen »von selbst« wachsende Quantenpunkte dar (siehe Heterostrukturen. Die so herstellbaren Quantenpunkte sind kleiner als man sie durch direktes Strukturieren von Quantenfilmen zur Zeit herstellen kann.
Ausrüstung
MBE-Prozesse finden grundsätzlich im Ultrahochvakuum statt (üblicherweise bei Drucken von einigen 10-14 bar). Das hat vor allem zwei Gründe: Definierte Molekularstrahlen können sich nur in einem Vakuum mit hinreichend grosser freier Weglänge ausbreiten. Ausserdem kommt es bei der Anlagerung des Materials auf dem Substrat zu einem Wettbewerb mit Hintergrundrestgasen, die im Gegensatz zum Material aus dem Molekularstrahl die ganze Zeit auf das Substrat einwirken und unter Umständen einen hohen Haftkoeffizienten - also eine hohe Wahrscheinlichkeit zur Adsorption und anschliessendem Einbau in die wachsende Schicht - haben (dies trifft insbesondere auf O und C zu; deren Verbindungen sollten deshalb nur mit einem Partialdruck von weniger als 10-13 mbar in der Kammer enthalten sein). Soll sichergestellt werden, dass bei einem langsamen Schichtwachstum im Bereich von mm / h hinreichend reine Schichten entstehen, sind die oben genannten niedrigen Arbeitsdrucke notwendig.
Eine Skizze zum Aufbau
einer MBE-Anlage ist in [20]Abb.1 dargestellt.
Als Quellen für die
Molekularstrahlen dienen normalerweise sogenannte Effusionszellen. Eine
schematische Darstellung eines verbreiteten Typs solcher Zellen ist in [21]Abb.2 gegeben. Bei vielen
MBE-Prozessen werden die einzelnen Bestandteile der zu wachsenden Strukturen in
elementarer Form in den Effusionszellen verdampft. Daneben gewinnen jedoch
Verfahren, bei denen mit Molekularstrahlen leicht flüchtiger Verbindungen der
Elemente gearbeitet wird, immer mehr an Bedeutung. Solche Methoden bezeichnet
man normalerweise als Metal Organic Molecular Beam Epitaxy (MOMBE). Ein kurzer
Vergleich der Vor- und Nachteile beider Methoden findet sich in der Tabelle.
Eine entscheidende Komponente eines MBE-Systems ist auch die Substratmontage: Idealerweise sollte diese im Hochvakuum selbst erfolgen können und sowohl eine Rotation des Substrats (zur Verbesserung der Homogenität) als auch die Kontrolle der Substrattemperatur zulassen.
Die Substrattemperatur ist ein entscheidender Parameter für die Qualität der MBE-Schichten. Bei geeigneten Temperaturen können auftreffende Atome an der Oberfläche bis zu einer Stufenkante diffundieren und werden dort gebunden. Bei zu hohen Temperaturen wird die Bindungswahrscheinlichkeit verringert, während bei zu niedrigen Temperaturen die Schichten rauh werden, da die Atome nicht mehr nur an Stufenkanten bevorzugt angelagert werden.
Perspektiven
In situ Analyse
Als UHV-Verfahren bietet die MBE vielfältige Möglichkeiten, die epitaktischen Schichten direkt während des Wachstums beispielsweise durch Elektronenbeugung oder durch Auger-Elektronenspektroskopie zu analysieren. Diese online-Kontrolle ermöglicht es einerseits, die Wachstumsrate zu bestimmen, und erlaubt andererseits auch eine sofortige Erkennung von Abweichungen vom erwünschten/erwarteten Wachstumsverhalten.
In situ Strukturierung
Mit Hilfe von
geeigneten Molekularstrahlen (z.B. AsBr3 oder AsCl3) können in der MBE Halbleiterstrukturen nicht
nur atomlagengenau aufgewachsen werden, sondern auch mit der gleichen
Genauigkeit wieder abgetragen werden (siehe [22]Abb.3). Dies erlaubt es, die MBE auch
zur Strukturierung der aufgewachsenen Schichten einzusetzen und auf die so
entstanden Strukturen unmittelbar neue Schichten anderer Zusammensetzung wieder
aufzuwachsen. Sowohl beim Wachstum als auch beim Ätzen gibt es in der MBE eine
deutliche Abhängigkeit der Raten von den jeweiligen Kristallflächen. Dies
erlaubt es, extrem feine Strukturen durch selektives Überwachsen
vorstrukturierter Substrate herzustellen.
Neue Materialsysteme
Neben der mittlerweile schon fast »klassischen« MBE von III-V-Halbleitern wie GaAs/AlGaAs wurden in den letzten Jahren zahlreiche Fortschritte bei der Herstellung von Schichten aus Nitriden der Elemente Al, Ga und In (vor allem für optoelektronische Bauelemente im blauen Spektralbereich von Bedeutung) sowie bei zunehmend komplexeren Gemischen von II-VI-Halbleitern (BeMgMnZnCdHgSSeTe), neuen III-V-Materialien und Gruppe IV-Halbleitern (SiGeCSn) gemacht. In allen Halbleitersystemen ist eine zunehmende Tendenz zu immer komplizierteren Legierungszusammensetzungen zu beobachten. Daneben gewinnt auch die MBE von Metallschichten immer grössere Bedeutung.
MBE in der industriellen Bauelementefertigung
MBE-Schichten spielen technisch vor allem für die Herstellung
schneller, rauscharmer Schaltelemente eine Rolle, wie sie z.B. in der
Mikrowellentechnik, für Mobiltelefone und ähnliche Geräte benötigt werden. [23]Abb.4 zeigt ein Foto einer MBE-Anlage
für die industrielle Produktion.
Molekularstrahlepitaxie: Vergleich der Vor- und Nachteile der MBE- und MOMBE-Methoden.
| bottom:solid black 1.5pt;border-right:
none;mso-border-top-alt:solid black .75pt;mso-border-left-alt:solid black .75pt;
mso-border-bottom-alt:solid black 1.5pt;padding:0cm 3.55pt 0cm 3.55pt\'>
MBE |
bottom:solid black 1.5pt;border-right:solid black 1.0pt;
mso-border-top-alt:solid black .75pt;mso-border-bottom-alt:solid black 1.5pt;
mso-border-right-alt:solid black .75pt;padding:0cm 3.55pt 0cm 3.55pt\'>
MOMBE |
|
feste Ausgangsstoffe aus Tiegeln verdampft |
leicht flüchtige Ausgangsstoffe treffen durch
Gaseinlasssysteme auf Substrat |
|
hohe Quellentemperatur |
keine hohen Quellentemperaturen |
|
vorwiegend physikalische Deposition auf Substrat |
chemische Zersetzung des Molekularstrahls auf dem Substrat |
|
geringe Gefährdung bei unbeabsichtigtem Austritt von
Quellenmaterial |
Gefährdung durch teilweise hochgiftige Gase in
Quellenmaterial |
|
Nur benötigte Substanzen in Molekularstrahlen enthalten |
Entstehung von Restsubstanzen bei Atomeinbau in Kristall |
| bottom:solid black 1.0pt;border-right:none;
mso-border-left-alt:solid black .75pt;mso-border-bottom-alt:solid black .75pt;
padding:0cm 3.55pt 0cm 3.55pt\'>
Haftkoeffizienten fest vorgegeben |
bottom:solid black 1.0pt;border-right:solid black 1.0pt;
mso-border-bottom-alt:solid black .75pt;mso-border-right-alt:solid black .75pt;
padding:0cm 3.55pt 0cm 3.55pt\'>
Unterschiedliche Haftkoeffizienten je nach genutzter
Verbindung |
bottom:.0001pt\'>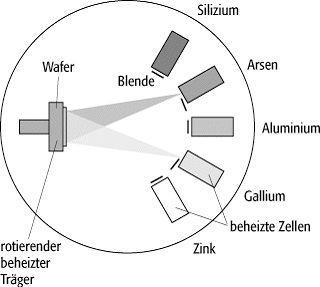
bottom:.0001pt\'>Molekularstrahlepitaxie 1: Schematischer Aufbau einer MBE-Anlage
bottom:.0001pt\'>
bottom:.0001pt\'>Molekularstrahlepitaxie 2: Schematischer Aufbau einer Effusionszelle.
bottom:.0001pt\'>
bottom:.0001pt\'>Molekularstrahlepitaxie 3: in-situ RHEED-Beobachtung des Aufwachsens (I), Abtragens(III) und Wiederaufwachsens (IV) einer GaAs-Schicht unter Verwendung von AsBr3 als Ätzmittel. Die RHEED-Oszillationen zeigen, dass die Wachstums- und Ätzprozesse weitgehend atomlagenweise erfolgen.
bottom:.0001pt\'>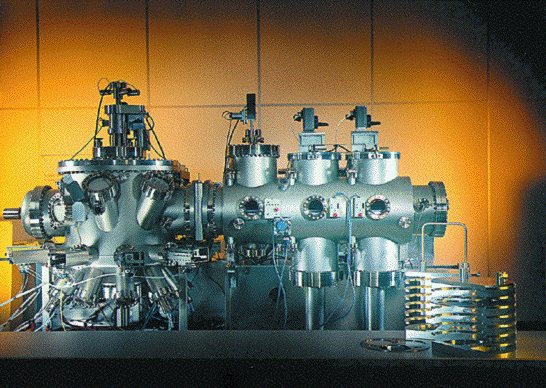
bottom:.0001pt\'>Molekularstrahlepitaxie 4: Production MBE System der Firma VG semicon.
Literatur:M.A. Herman, H. Sitter: Molecular Beam Epitaxy - Fundamentals and Current Status, 1996, Heidelberg, Springer.
A.Y. Cho: Applied Physics Letters 19 467, 1971.
Techniklexikon.net
Das freie Technik-Lexikon. Fundierte Informationen zu allen Fachgebieten der Ingenieurwissenschaften, für Wissenschaftler, Studenten, Praktiker & alle Interessierten. Professionell dargeboten und kostenlos zugängig.
Techniklexikon
Modernes Studium der Physik sollte allen zugängig gemacht werden.